發布日期:2022-10-09 點擊率:81
近年來,因為新能源汽車、光伏及儲能、各種電源應用等下游市場的驅動,碳化硅功率器件取得了長足發展。更快的開關速度,更好的溫度特性使得系統損耗大幅降低,效率提升,體積減小,從而實現變換器的高效高功率密度化。但是,像碳化硅這樣的寬帶隙(WBG)器件也給應用研發帶來了設計挑戰,因而業界對于碳化硅MOSFET平面柵和溝槽柵的選擇和權衡以及其浪涌電流、短路能力、柵極可靠性等仍心存疑慮。
碳化硅MOSFET性能如何?
650V-1200V電壓等級的SiC MOSFET商業產品已經從Gen 2發展到了Gen 3,隨著技術的發展,元胞寬度持續減小,比導通電阻持續降低,器件性能超越Si器件,浪涌電流、短路能力、柵氧可靠性等可靠性問題備受關注。那么SiC MOSFET體二極管能抗多大的浪涌電流?其短路能力如何?如何保證柵極可靠性?
SiCMOSFET的體二極管抗浪涌電流大小與芯片的大小成正比。像派恩杰半導體采用自己搭建的10ms正弦半波浪涌極限測試平臺和10us方波半波浪涌極限測試平臺對其1200V的SiC MOSFET P3M12080K3進行抽樣測試10msIFSM>120A, 10us IFSM>1100A。

圖110ms浪涌極限測試平臺

圖2 10us浪涌極限測試平臺
至于短路能力,相較與SiIGBT,SiCMOSFET電流密度更高且柵極氧化層較薄,其短路能力要弱于SiIGBT,但其依然有一定的短路能力。
下表是派恩杰半導體部分產品短路能力:
表11200V/650VMOSFET器件短路耐量
|
No. |
Value |
Unit |
Test Condition |
|
P3M12017K4 |
3.4 |
μS |
VDS = 800V, Rgon = 8.2Ω, Rgon = 7.5Ω, Vgs = -5/20V, Tj = 25℃ |
|
P3M12025K4 |
3.4 |
μS |
VDS = 800V, Rgon = 8.2Ω, Rgon = 7.5Ω, Vgs = -3/15V, Tj = 25℃ |
|
P3M12080K4 |
3.0 |
μS |
VDS = 800V, Rgon = 8.2Ω, Rgon = 7.5Ω, Vgs = -3/15V, Tj = 25℃ |
|
P3M06060K4 |
6.0 |
μS |
VDS = 400V, Rgon = 8.2Ω, Rgon = 7.5Ω, Vgs = -3/15V, Tj = 25℃ |
派恩杰半導體針對柵極的可靠性是嚴格按照AEC-Q101標準進行,在柵極分別加負壓和正壓(-4V/+15V)溫度175℃下進行HTGBR和HTRB實驗1000h無產品失效。除了常規AEC-Q101中要求的1000h小時實驗,派恩杰半導體對于柵極壽命經行了大量研究。由于SiC/SiO2界面存在比Si/SiO2更大數量級的雜質缺陷,因此SiCMOSFET通常擁有更高的早期失效概率。為了提高SiCMOSFET的柵極可靠性,通過篩選識別并出早期失效非常重要。派恩杰半導體通過TDDB實驗建立柵氧加速模型并建立篩選機制來消除潛在的失效可能性器件(可見往期推送)。
除了TDDB外,當正常器件使用時,由于半導體-氧化界面處缺陷的產生或充放電,SiCMOSFET的閾值電壓會有漂移現象,閾值電壓的漂移可能對器件長期運行產生明顯影響。派恩杰半導體在高溫條件下給SiC MOSFET施加恒定的DC偏壓,觀察其閾值電壓的變化量。一般施加正向偏壓應力時,閾值電壓向更高的電壓偏移;施加負向偏壓應力時,閾值電壓向更低的電壓偏移。這種效應是由于SiC/SiO2界面處或附近的載流子捕獲引起的,負向高壓是MOS界面附近的空穴被俘獲,產生更多的空穴陷阱;相反正向高壓造成電子的俘獲。當然,也有的競品產品在施加正向偏壓應力時,閾值電壓向更低的電壓偏移;施加負向偏壓應力時,閾值電壓向更高的電壓偏移。這是由于可移動離子在SiC/SiO2界面積累造成的,正向的偏壓使得正性的可移動離子在SiO2/SiC界面積累,造成閾值電壓負向漂移;負向的偏壓使得正性的可移動離子在poly/SiO2界面積累,造成閾值電壓正偏。為評估器件在使用過程中閾值電壓漂移情況,派恩杰半導體進行了大量BTI實驗,基于實驗數據建立了PBTI&NBTI模型,借助模型可知曉器件在不同溫度和柵壓情況下的閾值電壓漂移程度。以P3M12080K4產品為例,該產品在極端應用情況下(PBTI:Vgs=19V,TA=150℃)使用20年閾值電壓的漂移情況(+0.348V),該產品在極端應用情況下(NBTI:Vgs=-8V,TA=150℃)使用20年閾值電壓的漂移情況(-0.17V)。
Cascode、平面柵、溝槽柵優缺點
為提高高壓電源系統能源效率,半導體業者無不積極研發經濟型高性能碳化硅功率器件,例如Cascode結構、碳化硅MOSFET平面柵結構、碳化硅MOSFET溝槽柵結構等。這些不同的技術對于碳化硅功率器件應用到底有什么影響,該如何選擇呢?
首先,Cascode是指采用SiMOSFET和常開型的SiCJFET串聯連接,如圖3所示。當SiMOSFET柵極為高電平時,MOSFET導通使得SiCJFET的GS短路,從而使其導通。當SiMOSFET柵極為低電平時,其漏極電壓上升直至使SiCJFET的GS電壓達到其關斷的負壓時,這時器件關斷。Cascode結構主要的優點是相同的導通電阻有更小的芯片面積,由于柵極開關由SiMOSFET控制,使得客戶在應用中可以沿用Si的驅動設計,不需要單獨設計驅動電路。
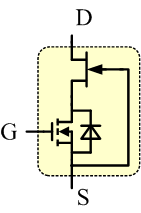
圖3SiCCascode結構示意圖
派恩杰半導體認為,Cascode結構只是從Si產品轉向SiC產品的一個過渡產品,因為Cascode結構完全無法發揮出SiC器件的獨特優勢。首先,由于集成了SiMOSFET限制了Cascode的高溫應用,特別是其高溫Rdson會達到常溫下的2倍;其次,器件開關是由SiMOSFET控制,因此開關頻率遠低于正常SiCMOSFET器件,這是由于JFET和SiMOSFET的合封其dv/dt也只能達到10V/ns以下,而SiCMOSFET的dv/dt通常可以到達30V/ns~80V/ns。這些缺點使得Cascode也無法減小無源元件的尺寸,從而達到減小整體系統體積和成本的需求;最后,雖然從Cascode結構上是由SiC高壓JFET器件來承受母線電壓,但是在開關過程中,MOSFET和JFET的輸出電容依然會分壓,當回路中存在電壓震蕩時,低壓SiMOSFET依然有被擊穿的風險。
SiCMOSFET溝槽柵的主要優勢來源于縱向溝道,這不但提高了載流子遷移率(這是由于SiC(11)晶面的遷移率高于(0001)晶面)而且可以縮小元胞尺寸從而有比平面型MOSFET更低的比導通電阻。然而,由于SiC非常堅硬,想要獲得均勻,光滑且垂直的刻蝕表面的工藝難度和控制要求都非常的高,這也是只有英飛凌和Rohm推出溝槽柵SiCMOSFET的原因。溝槽柵工藝不僅對工藝實現要求非常高,在可靠性方面也存在一定的風險。首先,由于溝槽刻蝕后表面粗糙度和角度的限制使得溝槽柵的柵氧質量存在風險;其次,由于SiC的各向異性,溝槽側壁的氧化層厚度和溝槽底部的氧化層厚度不同,因此必須采用特殊的結構和工藝來避免溝槽底部特別是拐角部分的擊穿,這也增加了溝槽柵柵氧可靠性的不確定性;最后,由于trench MOSFET的結構,使得trench柵氧的電場強度要高于平面型,這也是Infineon和Rohm要做單邊和雙溝槽的原因。
SiCMOSFET平面柵則是最早也是應用最廣泛的結構,目前主流的產品均使用該結構。派恩杰半導體產品采用的是也是平面柵MOSFET結構。基于平面柵結構,派恩杰已經發布了650V-1700V各個電壓平臺的SiC MOSFET,而且已經順利在新能源龍頭企業批量供貨,實現“上車”。

下一篇: PLC、DCS、FCS三大控
上一篇: 非互補有源鉗位可實現